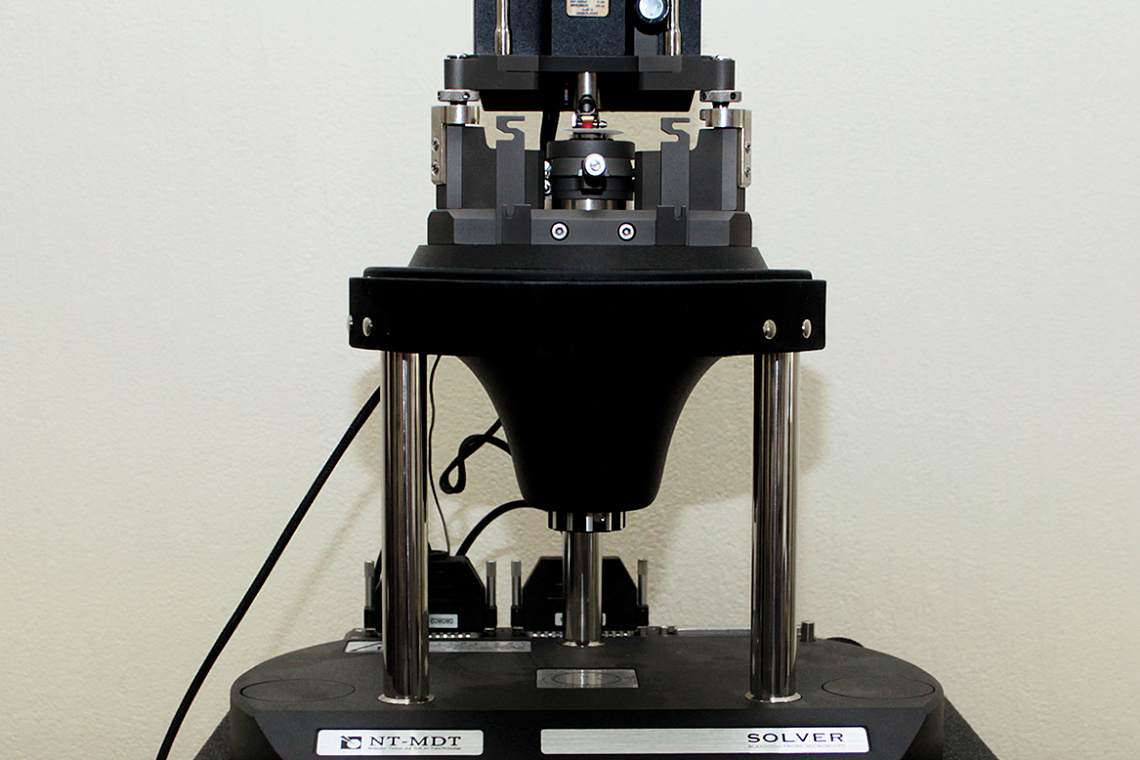
Электронная, зондовая и оптическая микроскопия
Исследовательский комплекс Solver Pro M для атомно-силовой микроскопии
Предназначен для получения изображений поверхности с высоким пространственным разрешением, измерения линейных размеров элементов топологии микро- и нанорельефа поверхности твердых тел с разным типом проводимости, наноструктур, а также для диагностики локальных физических свойств.
Предполагает возможность использования следующих методик:
- Контактная атомно-силовая микроскопия (АСМ);
- Микроскопия латеральных сил (МЛС);
- Резонансная АСМ (полуконтактная + безконтактная);
- Метод отображения Фазы;
- Метод модуляции силы;
- Изображение Силы Адгезии;
- Отображение сопротивления растекания;
- Метод зонда Кельвина (МЗК);
- Магнитно-силовая Микроскопия (МСМ).
Загрузка прибора (%):
30
Загрузка прибора по дням (не менять):
2020/12/01,2020/12/02,2020/12/04,2020/12/18,2020/12/29,2020/12/30,2021/01/01,2021/01/12,2021/01/20,2021/01/21,2021/01/28,2021/02/01,2021/02/03,2021/02/11,2021/02/17,2021/02/19,2021/02/24
Пример исследования:
Исследование топографии подложек различной конфигурации поверхности.
Изучение тонких полупроводниковых пленок и двумерных ансамблей методами атомно-силовой микроскопии (топография, фазовый контраст, режим модуляции силы, режимы контактного и полуконтактного рассогласования).
Исследование доменной структуры поверхности кристаллов ниобата лития.
Технические характеристики:
|
Диапазон измерений линейных размеров в плоскости XY
|
5 нм-100 мкм
|
|
Диапазон позиционирования
|
5x5 мм
|
|
Разрешение позиционирования
|
5 мкм
|
|
Сканирующая измерительная головка - область сканирования
|
100х100х7 мкм (+/-10 %)
|
|
Нелинейность
|
не хуже 0,4 % (быстрое направление)
0,5 % (медленное направление)
|
|
Размеры образца
|
максимальный размер образца до 100 мм в диаметре и до 20 мм по высоте, либо неограниченный с измерительной головкой, используемой в качестве выносной
|
Дополнительные фото:
Загрузить